產品新知
3D封裝正夯! 這裡將為您揭曉高效能的封裝材料

隨著5G 和 AI 時代的來臨,半導體封裝技術因應高密度多功能的多晶產品需求,以及更小、更薄的封裝發展趨勢,在性能、成本、空間上的考量,SiP 成為微型化系統的解決方案,同時也對於封裝材料的使用方式、規格及信賴度的要求更加嚴苛。
在新式2.5D或3D的封裝形式中(SiP、PiP、PoP),晶片封裝的材料應用會著重在錫球保護、超高導熱介面材料及增加製程穩定度的方向。YINCAE這15年來致力於開發高功能型的封裝材料,除了能提供符合客戶更快速、更高效的應用產品,更擁有豐富的製程經驗以協助客戶針對不同的產品需求進行開發設計。
針對3D封裝製程的需求,喬越集團代理之YINCAE提供了不同的底部填充材料(Underfill)的選擇方案,有可適用於Dipping製程的錫球保護膠,也有可應用於溫度測試條件嚴苛的車用電子元件材料。同時對於晶片製程微小化所產生的導熱需求,有高導熱率(60 W/mK)的接著膠之外,還有具導熱效果的underfill,可有效增加立體封裝熱傳導的路徑。YINCAE 的封裝材料,不但能有效並直接的提供客戶在製程上的需求。同時也能搭配喬越集團提供的相關電子膠材,滿足各式產品在接著封裝的應用。
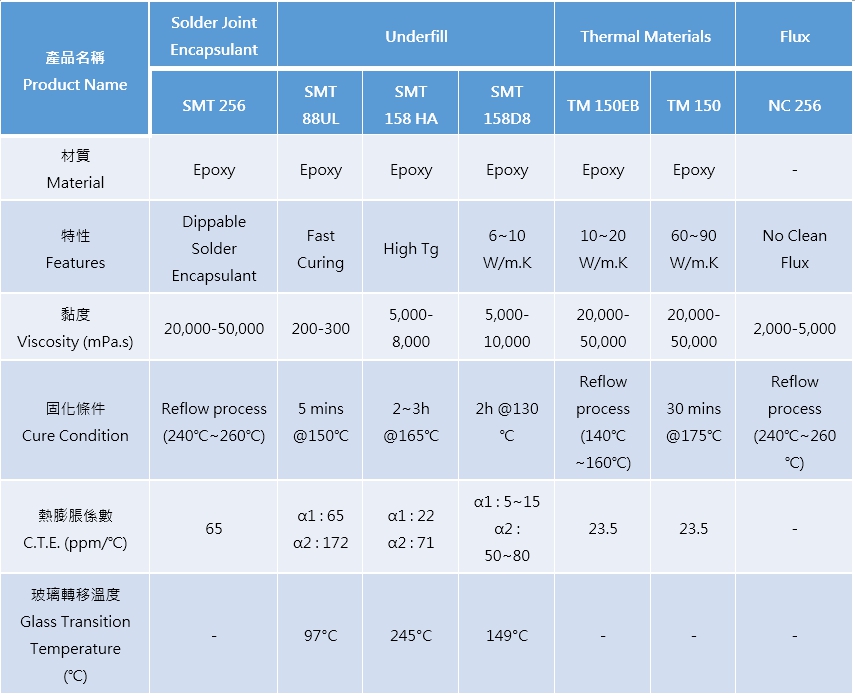
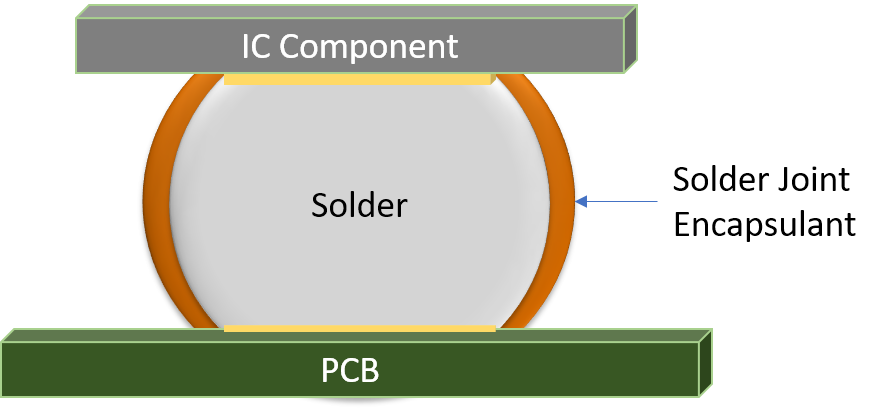
參考資料:
https://reurl.cc/GrL1RG
https://reurl.cc/N6LWmk
https://pse.is/38e24d
※喬越集團為全方位電子應用膠材專家,欲瞭解此產品資訊,歡迎來電+886-2-85122222或 點擊此處填妥基本資料送出,將會有專業的業務團隊立即與您連絡。
